縱觀中國(guó)集成電路產(chǎn)業(yè),封裝測(cè)試行業(yè)發(fā)展尤其迅速。隨著國(guó)內(nèi)高附加值芯片設(shè)計(jì)企業(yè)的快速發(fā)展,直接帶動(dòng)了產(chǎn)業(yè)下游的集成電路封裝和測(cè)試。

國(guó)內(nèi)芯片封測(cè)企業(yè)現(xiàn)狀
2019年,中國(guó)大陸芯片封裝、測(cè)試的廠家超過了120個(gè)。芯片封裝、測(cè)試行業(yè)的營(yíng)收總額超過了2349億元人民幣,相比上一年增幅為7.10%,遠(yuǎn)超全球的平均增幅。可以說,芯片封裝、測(cè)試行業(yè)已經(jīng)成為大陸半導(dǎo)體產(chǎn)業(yè)鏈中最具實(shí)力的環(huán)節(jié)。
雖然中國(guó)大陸的芯片封測(cè)企業(yè)正在快速崛起,但是外資企業(yè)占據(jù)國(guó)內(nèi)封測(cè)市場(chǎng)的份額依舊很大,封測(cè)市場(chǎng)國(guó)產(chǎn)化還有很大的提升空間。
雖然部分芯片封測(cè)企業(yè)的技術(shù)已經(jīng)達(dá)到國(guó)際領(lǐng)先水平,但整體的發(fā)展程度仍與國(guó)外存在一定的差距。在半導(dǎo)體芯片產(chǎn)業(yè)中,隨著數(shù)模混合芯片、特殊電路芯片和高速寬帶網(wǎng)絡(luò)芯片等高端封測(cè)產(chǎn)品需求的不斷提升,推動(dòng)了芯片封測(cè)技術(shù)的不斷提高。

芯片封裝技術(shù)發(fā)展歷程
當(dāng)下,全球范圍內(nèi)主流的芯片封裝形式主要集中在第三階段至第五階段。其中,第三階段主要是芯片級(jí)封裝(CSP)和球柵陣列封裝(BGA),第四、五階段主要是系統(tǒng)級(jí)封裝(SIP)、系統(tǒng)級(jí)單芯片封裝(SOC)和晶圓級(jí)系統(tǒng)封裝(TSV)。
最近幾年,國(guó)內(nèi)一部分芯片封裝、測(cè)試企業(yè)通過并購(gòu)和研發(fā)的方式,已經(jīng)在主流的封測(cè)形式上達(dá)到了國(guó)際領(lǐng)先水平。但是,大部分國(guó)內(nèi)封測(cè)企業(yè)仍停留在第二和第三階段,在整體上與國(guó)外企業(yè)存在差距。
先進(jìn)封裝的發(fā)展趨勢(shì)
芯片封裝可以分為先進(jìn)封裝和傳統(tǒng)封裝。根據(jù)著名半導(dǎo)體分析機(jī)構(gòu)Yole Developpement的劃分,先進(jìn)封裝包括Fan-in WLP、Embedded Die、Flip-Chip、3D stacking和Fan-out,劃分的依據(jù)為產(chǎn)品的封裝技術(shù)、封裝形式、封裝材料和工藝復(fù)雜程度。傳統(tǒng)封裝也有其優(yōu)點(diǎn),包括使用成本低、性價(jià)比高、應(yīng)用領(lǐng)域廣和產(chǎn)品通用性強(qiáng),因此傳統(tǒng)封裝和先進(jìn)封裝各有優(yōu)勢(shì),可以服務(wù)各自不同層面的客戶。
根據(jù)Yole的預(yù)計(jì),從2019年到2025年,全球傳統(tǒng)封裝市場(chǎng)將以1.9%的年復(fù)合增長(zhǎng)率增長(zhǎng)。而在車規(guī)芯片、5G通信終端、數(shù)據(jù)中心和高性能計(jì)算等領(lǐng)域的刺激下,先進(jìn)封裝更是前景一片大好。Yole預(yù)測(cè),先進(jìn)封裝在2019年-2025年將以6.6%的年復(fù)合增長(zhǎng)率增長(zhǎng)。
現(xiàn)階段,先進(jìn)封裝的技術(shù)路徑主要分為SiP和WLP。從整體上來看,封裝技術(shù)正朝著集成化和小型化的趨勢(shì)邁進(jìn)。根據(jù)摩爾定律,每隔18個(gè)月左右,集成電路可以容納的晶體管數(shù)量將翻一倍。芯片設(shè)計(jì)領(lǐng)域正好將要進(jìn)入瓶頸期,半導(dǎo)體產(chǎn)業(yè)越來越重視材料和封裝技術(shù)的革新。
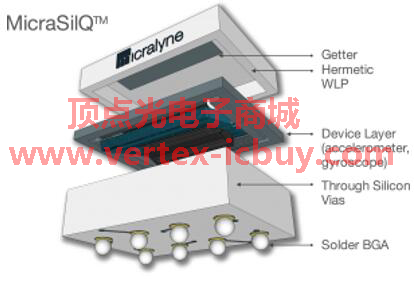
封裝技術(shù)小型化,也可以統(tǒng)稱為WLP(晶圓芯片封裝),即以晶圓級(jí)作為芯片封裝的尺寸。另一種先進(jìn)封裝技術(shù)SiP(系統(tǒng)級(jí)封裝),是將多個(gè)小型半導(dǎo)體材料(Die)封裝在一起,以提高整個(gè)電路的集成度。
從整體來看,芯片封裝技術(shù)經(jīng)過了從引線框架(DIP/SOP/QFP/QFN)到焊線正裝(WB-BGA),再到倒裝(FC-BGA),然后是晶圓級(jí)封裝(WLP)的歷程。在這個(gè)發(fā)展過程中,單位芯片面積可以搭載的I/O模塊越來越多,芯片封裝的尺寸越來越小,厚度越來越薄。
WLP的特點(diǎn)是,直接在晶圓上進(jìn)行封裝和測(cè)試,然后再?gòu)木A上切割,這是其與傳統(tǒng)封裝的最大區(qū)別。WLP又可以分為扇入封裝(Fan-in)和扇出封裝(Fan-out)。相比于傳統(tǒng)封裝技術(shù),WLP的體積更小、散熱更好,特別是在晶圓尺寸越大、芯片尺寸越小的情況下,封裝效率就越高,成本越低。在當(dāng)今晶圓尺寸以8英寸和12英寸為主,芯片制程工藝朝著3nm、2nm方向發(fā)展的趨勢(shì)下,WLP已經(jīng)越來越受到重視了。
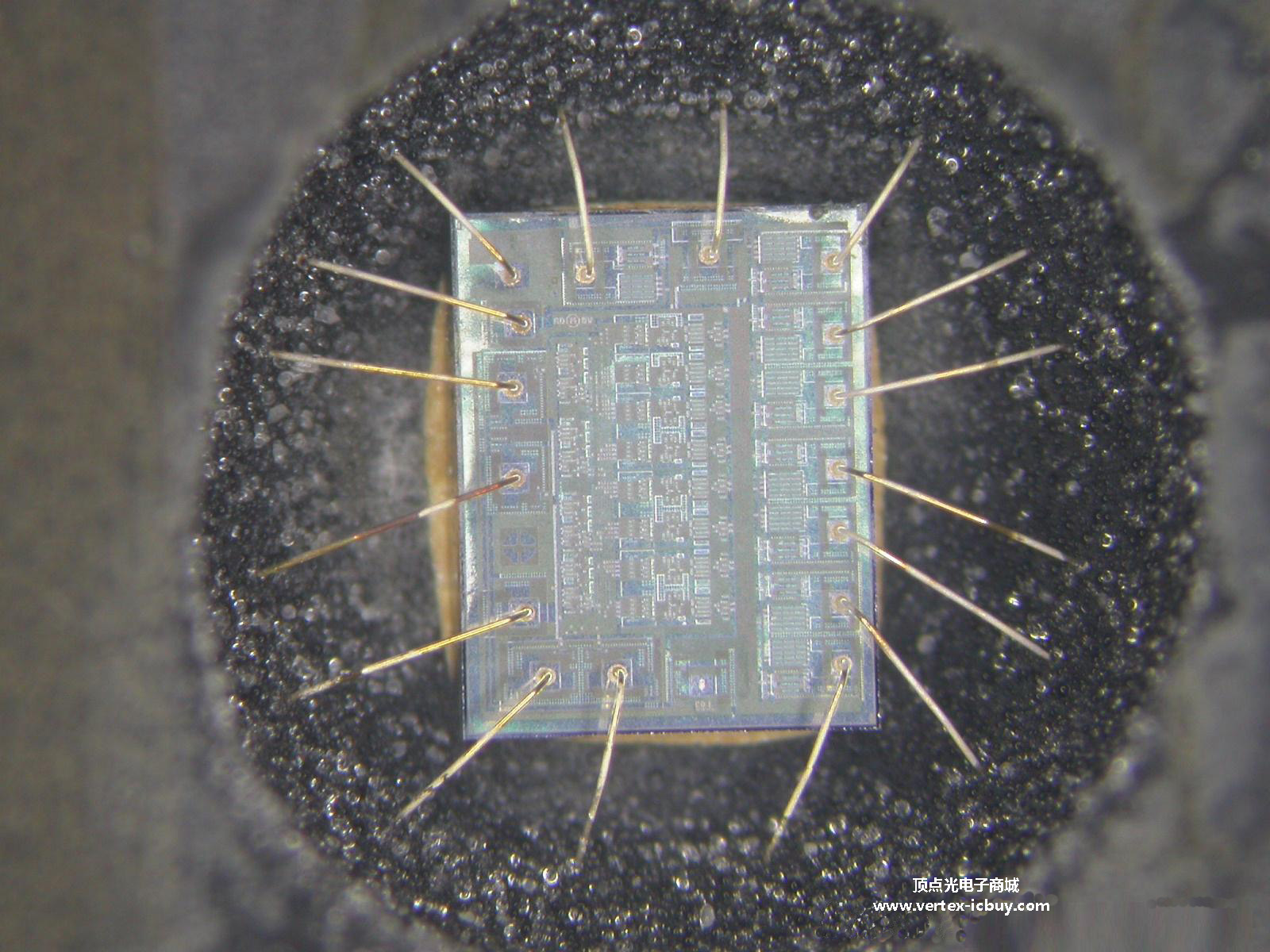
芯片封裝在X-Ray下的景象
由于摩爾定律的存在,單個(gè)芯片的性能受到局限。因此,出現(xiàn)了一種將不同功能的芯片和無(wú)源元件封裝在一個(gè)模塊中,各芯片之間的信號(hào)傳輸不通過印制電路板( Printed Circuit Board,簡(jiǎn)稱PCB),這樣就繞開了摩爾定律,實(shí)現(xiàn)了集成電路整體性能的提升。這種封裝方式就是SiP。
SiP主要應(yīng)用與智能手機(jī)市場(chǎng)。由于智能手機(jī)的輕薄化,必須保證內(nèi)部的電子元器件小型化。SiP的集成化封裝,不僅可以減小電子元器件的尺寸,還能降低智能手機(jī)的組裝難度,節(jié)約BOM成本,因此在智能手機(jī)市場(chǎng),特別是高端旗艦機(jī)上得到了廣泛的應(yīng)用。除了智能手機(jī),SiP還被應(yīng)用到軍工、通信、車規(guī)芯片等。
先進(jìn)封裝的最大應(yīng)用領(lǐng)域是消費(fèi)電子。根據(jù)Yole的統(tǒng)計(jì)數(shù)據(jù),2019年,先進(jìn)封裝占據(jù)了消費(fèi)電子市場(chǎng)的86%,并且將以6%的年復(fù)合增長(zhǎng)率一直持續(xù)增長(zhǎng)到2025年。不過,通信設(shè)施正在以非常快的速度追趕消費(fèi)電子。據(jù)統(tǒng)計(jì),通信設(shè)施將以12.8%的年復(fù)合增長(zhǎng)率,迅速先進(jìn)封裝化。到2025年,先進(jìn)封裝將占據(jù)通信設(shè)施的14%。
國(guó)內(nèi)芯片封測(cè)企業(yè)盈利狀況
芯片封測(cè)行業(yè)是一個(gè)重資本、重技術(shù)的行業(yè),因此,對(duì)資金和人才儲(chǔ)備有較高的要求。購(gòu)置設(shè)備占據(jù)了資本投入的大部分,導(dǎo)致固定成本占比較高。由于半導(dǎo)體行業(yè)對(duì)封測(cè)技術(shù)的要求越來越高,技術(shù)研發(fā)和人才引進(jìn)也占據(jù)了很大一部分的資本支出。因此,芯片封測(cè)是一個(gè)資本和人才密集型行業(yè),企業(yè)面臨相對(duì)較高的人工成本和固定資產(chǎn)折舊。例如,2019年,長(zhǎng)電科技的在職員工達(dá)到了2.3萬(wàn)多人,固定資產(chǎn)規(guī)模為178億元,占總資產(chǎn)的一半多。
為了追趕國(guó)際先進(jìn)封測(cè)企業(yè),近年來國(guó)內(nèi)企業(yè)紛紛加大了資本支出。并且,集成電路行業(yè)具有技術(shù)更新?lián)Q代快的特點(diǎn),這也要求封測(cè)企業(yè)不斷革新自己的技術(shù)。以中國(guó)大陸封測(cè)企業(yè)的領(lǐng)軍者為例,2019年,通富微電、華天科技和長(zhǎng)電科技的資本支出占營(yíng)收的比例分別為25.51%、24.13和11.92%。

通富微電的封測(cè)車間
在固定資產(chǎn)折舊和人工成本方面,2019年,華天科技、通富微電和長(zhǎng)電科技的固定資產(chǎn)折舊占營(yíng)收的比例分別為14.69%、14.49%和12.78%;人工成本占營(yíng)收的比例分別是21.20%、14.68%和16.57%。從總體來看,國(guó)內(nèi)主要封測(cè)企業(yè)的固定資產(chǎn)折舊和人工成本占營(yíng)收的平均比例為31.47%。
重資產(chǎn)和勞動(dòng)密集的特性,嚴(yán)重制約國(guó)內(nèi)封測(cè)企業(yè)的盈利能力。還是以華天科技、通富微電和長(zhǎng)電科技為例,2019年,他們的毛利率分別為16.33%、13.67%和11.18%,實(shí)現(xiàn)歸屬母公司凈利潤(rùn)率分別為3.54%、0.23%和0.38%。整體的盈利能力普遍較弱。
另外,國(guó)內(nèi)封測(cè)企業(yè)在客戶結(jié)構(gòu)上仍需要改善。國(guó)內(nèi)封測(cè)企業(yè)的客戶主要是國(guó)內(nèi)的IC設(shè)計(jì)企業(yè)和半導(dǎo)體制造企業(yè),但是國(guó)內(nèi)的IC設(shè)計(jì)企業(yè)和半導(dǎo)體制造企業(yè)與相應(yīng)的國(guó)際龍頭企業(yè)還是有一定的差距,這直接影響封測(cè)企業(yè)的業(yè)務(wù)量。例如,中國(guó)臺(tái)灣地區(qū)的封測(cè)企業(yè)日月光,憑借與臺(tái)積電的合作關(guān)系,發(fā)展成了全球最大的芯片封裝測(cè)試廠商。中國(guó)大陸最先進(jìn)的半導(dǎo)體制造商中芯國(guó)際與臺(tái)積電還有不小的差距。國(guó)內(nèi)封測(cè)企業(yè)在不斷革新技術(shù)的同時(shí),還需要加強(qiáng)海外超級(jí)客戶的拓展。
雖然在先天上不具備優(yōu)勢(shì),但還是要從全局來看國(guó)內(nèi)封測(cè)企業(yè)的發(fā)展。在2019年,大陸IC設(shè)計(jì)企業(yè)的總營(yíng)收達(dá)到了3063.5億元,相比上一年同期增幅為21.6%;半導(dǎo)體制造企業(yè)的總營(yíng)收達(dá)到了2149.1億元,相比上一年同期增幅18.2%。中國(guó)大陸半導(dǎo)體行業(yè)整體發(fā)展迅速,在上游IC設(shè)計(jì)和半導(dǎo)體制造企業(yè)的帶動(dòng)下,國(guó)內(nèi)封測(cè)企業(yè)的發(fā)展也將長(zhǎng)期獲益。
>>>相關(guān)閱讀:IDM與垂直分工---集成電路的模式之爭(zhēng) 中國(guó)封測(cè)行業(yè)逐步崛起
 鄂公網(wǎng)安備 42011502001385號(hào) 鄂ICP備2021012849號(hào)
鄂公網(wǎng)安備 42011502001385號(hào) 鄂ICP備2021012849號(hào)